半導体(ICやトランジスタ)のパッケージの種類は多すぎる!
例えば、SOPやQFNやBGAなどがパッケージ名称としてありますが、どのパッケージがどの形を表すかを理解するのはとても大変だと思います。
そのため、この記事では各パッケージの種類と特徴などを図を用いて分かりやすくまとめました。ご参考になれば幸いです。
パッケージの種類

上図にパッケージの分類を示しています。パッケージは
- 『挿入実装用』か『表面実装用』か
- 端子(リードなど)が『1側面から出ている』か『2側面から出ている』か『4側面から出ている』か『格子状に出ている』か
の観点で大きく分類することができます。
ではこれから各パッケージについて詳しく説明していきます。
あわせて読みたい
上図に示したパッケージ以外にもSOT(SOT-23など)やSOD(SOD-323など)やTO(TO-220など)などがあります。
SOT(SOT-23など)やSOD(SOD-323など)やTO(TO-220など)については下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。
-

【SOT】パッケージの『種類(SOT-23など)』と『特徴』を解説!
続きを見る
-



【SOD】パッケージの『種類(SOD-323など)』と『特徴』を解説!
続きを見る
-



【TO】パッケージの『種類(TO-220やTO-92など)』と『特徴』を解説!
続きを見る
挿入実装用のパッケージの種類


挿入実装用のパッケージにはSIP,DIP,ZIP,LGAがあります。
SIP,DIP,ZIPの要点を下記に示します(LGAについては後ほど詳しく説明します)。
挿入実装用パッケージの種類
- SIP(Single In-line Package)
- リードがパッケージの1側面から出ており、リードが1列に出ている。
- ZIP(Zigzag In-line Package)
- リードがパッケージの1側面から出ており、リードがジグザグ状に出ている。
- DIP(Dual In-line Package)
- リードがパッケージの2側面から出ており、リードが下方向に出ている。
では各パッケージについて順番に説明してきます。
パッケージの1側面からリードが出ているパッケージ
パッケージの1側面からリードが出ているパッケージにはSIPとZIPがあります。各パッケージの特徴は以下のようになっています。
SIP


SIPは『Single In-line Package』の頭文字をとったものです。
SIPはリードがパッケージの1側面から出ており、リードが1列であり、挿入実装用であるパッケージとなっています。SILと呼ばれることもあります。
SIPの後に付く数字はピン数を表します。例えば、SIP10の場合、10ピンのSIPとなります。
パッケージの長辺側にリード(はんだを接続するためのピン)を配置しており、プリント基板には立てて実装します。そのため、後ほど説明するDIPと比較すると、実装密度を上げることができます。
パッケージの1側面からのみリードが出ている構造なので、ピン数をあまり増やすことができません。そのため、小規模なICのパッケージに使われることが多くなっています。また、パッケージ面に放熱用の金属が付けられる構造です。そのため、ある程度発熱する部品(モータドライバICなど)に使われることが多くなっています。
また、SIPはICだけでなく、ネットワーク抵抗や放熱が必要なトランジスタアレイなどにも使われています。
SIPでも様々な種類があります(HSIP,P-SIPなど)。
あわせて読みたい
『SIP(Single In-line Package)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る


『SIP』とは?パッケージの種類を解説!【半導体&IC】
ZIP


ZIPは『Zigzag In-line Package』の頭文字をとったものです。
ZIPはリードがパッケージの1側面から交互にジグザグ状に出ている挿入実装用パッケージとなっています。
パッケージの1側面からリードが出ている点はSIPと同じですが、ZIPはリードをジグザグ状にすることで、ピンピッチを短くすることができるため、長辺を短くすることが可能となります。パッケージ面を正面から見るとピンピッチは1.27mm(50ミル)ですが、プリント基板に挿入するときには2.54mm(100ミル)となります。
SIPと同様にパッケージ面に放熱用の金属が付けられる構造です。そのため、ある程度発熱する部品(モータドライバICなど)に使われることが多くなっています。
ZIPでも様々な種類があります(SZIP,HZIPなど)。
あわせて読みたい
『ZIP(Zigzag In-line Package)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る


『ZIP』とは?パッケージの種類を解説!【半導体&IC】
パッケージの2側面からリードが出ているパッケージ
DIP


DIPは『Dual In-line Package』の頭文字をとったものです。
DIPはリードがパッケージの2側面から出ており、挿入実装用であるパッケージとなっています。パッケージの長辺の2側面からリードが下方向にリードが伸びています。DILと呼ばれることもあります。
ピンピッチは様々な距離があります。通常2.54mm(100ミル)だが、1.778mm(70ミル)のものもあります。パッケージの幅は15.2mm(600ミル)、10.16mm(400ミル)、7.62mm(300ミル)などがあります。
DIPでも様々な種類があります(SDIP,HSDIPなど)。
あわせて読みたい
『DIP(Dual In-line Package)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る


『DIP』とは?パッケージの種類を解説!【半導体&IC】
表面実装用のパッケージの種類
表面実装用のパッケージには下記の種類があります。
表面実装用パッケージの種類
- パッケージの2側面からリードが出ているパッケージ
- SOP,SOJ,SON等
- パッケージの4側面からリードが出ているパッケージ
- QFP,QFJ,QFN等
- パッケージの底面から格子状に端子が配置されているパッケージ
- BGA,LGA,PGA等
パッケージの2側面からリードが出ているパッケージ


パッケージの2側面からリードが出ているパッケージにはSOが付くものが多いです。SOは『Small Outline』の頭文字をとったものです。リードの形状はSOの後に来る英文字で決まり、以下のようになります。
SOパッケージのリード形状
- SOP:ガルウィング形
- SOJ:J字形
- SON:ノンリード(リードなし)
- SOI:I字形
- SOF:フラットリード形
SOP,SOJ,SON,SOI,SOFの特徴は以下のようになっています。
SOP
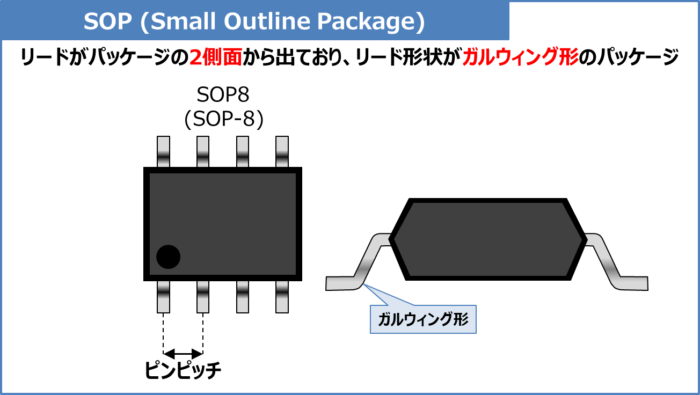
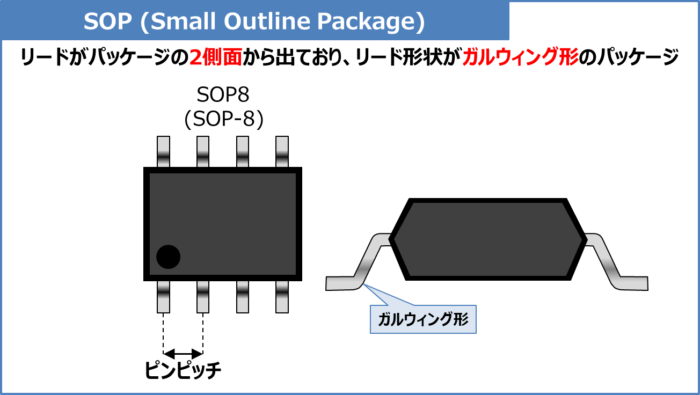
SOPは『Small Outline Package』の頭文字をとったものです。
SOPはリードがパッケージの2側面から出ており、リード形状がガルウィング形(L字形)のパッケージとなっています。ピンピッチは1.27mmが一般的です。
SOPの後に付く数字はピン数を表します。例えば、SOP8の場合、8ピンのSOPとなります。
『SOP』と似ているパッケージに『SOIC』があります。ピンピッチが1.27mmのパッケージにおいて、JEITA規格のものは『SOP』、JEDEC規格のものは『SOIC』となります。ピンピッチは同じですが、パッケージのボディ幅が異なるので注意してください。なお、SOICは『Small Outline Integrated Circuit』の頭文字をとったものであり、『SOL(Small Outline L-leaded package)』や『SO』と表記されることもあります。
なお、ガルウィング形(L字形)のリードがパッケージの4側面から出ているものは、QFP(Quad Flat Package)と呼ばれています。
SOPでも様々な種類があります(SSOP,MSOPなど)。
あわせて読みたい
『SOP(Small Outline Package)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る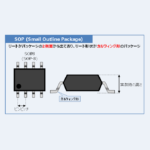
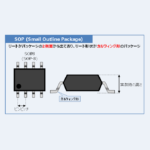
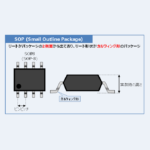
『SOP』とは?パッケージの種類を解説!【半導体&IC】
SOJ
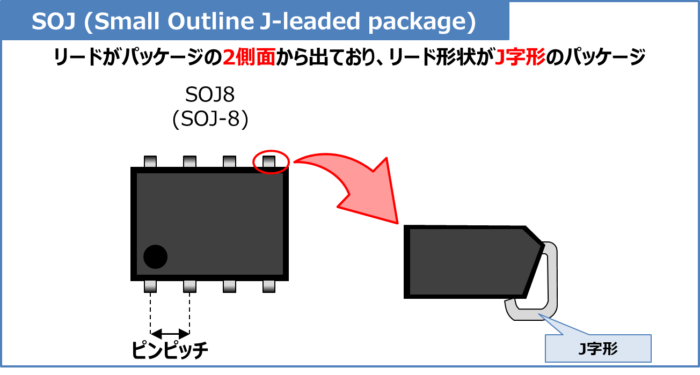
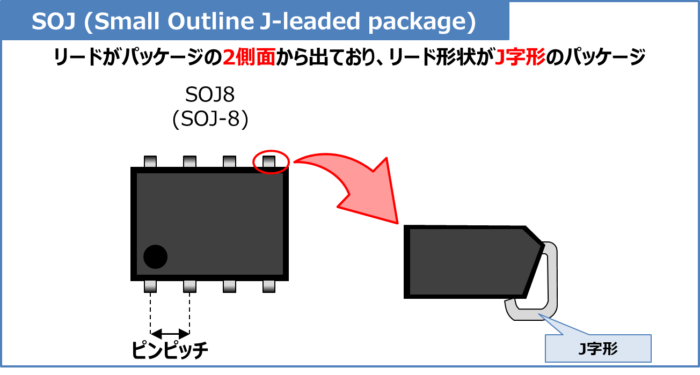
SOJは『Small Outline J-leaded package』の頭文字をとったものです。
SOJはリードがパッケージの2側面から出ており、リード形状がJ字形のパッケージとなっています。ピンピッチは1.27mmが一般的です。
SOJの後に付く数字はピン数を表します。例えば、SOJ8の場合、8ピンのSOJとなります。
リード形状がガルウィング形(L字形)であるSOPと比較すると、リード形状がJ字形であるSOJはリードが変形しにくというメリットがあります。
なお、J字形のリードがパッケージの4側面から出ているものは、QFJ(Quad Flat J-leaded package)と呼ばれています。
SOJでも様々な種類があります(P-SOJ,C-SOJなど)。
あわせて読みたい
『SOJ(Small Outline J-leaded package)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る


『SOJ』とは?パッケージの種類を解説!【半導体&IC】
SON
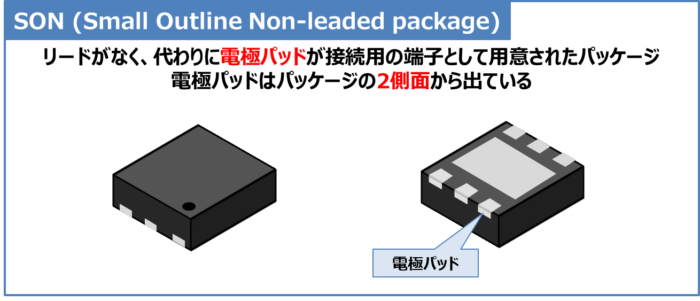
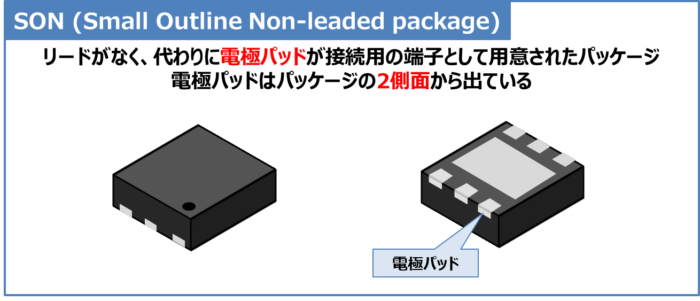
SONは『Small Outline Non-leaded package』の頭文字をとったものです。
SONはリードがなく、代わりに電極パッドが接続用の端子として用意されたパッケージとなっています。電極パッドはパッケージの2側面から出ています。
リードがないため、チップサイズとほぼ同じ大きさでパッケージを製作することができます。
なお、電極パッドがパッケージの4側面から出ているものは、QFN(Quad Flat Non-leaded package)と呼ばれています。
SONでも様々な種類があります(LSON,TSONなど)。
あわせて読みたい
『SON(Small Outline Non-leaded package)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る


『SON』とは?パッケージの種類を解説!【半導体&IC】
SOI
SOIは『Small Outline I-leaded package』の頭文字をとったものです。
SOIはリードがパッケージの2側面から出ており、リード形状がI字形のパッケージとなっています。
なお、I字形のリードがパッケージの4側面から出ているものは、QFI(Quad Flat I-leaded package)と呼ばれています。
SOF
SOFは『Small Outline F-leaded package』の頭文字をとったものです。
SOFはリードがパッケージの2側面から出ており、リード形状が直線形(フラットリード形)のパッケージとなっています。
なお、直線形(フラットリード形)のリードがパッケージの4側面から出ているものは、QFJ(Quad Flat F-leaded package)と呼ばれています。
パッケージの4側面からリードが出ているパッケージ
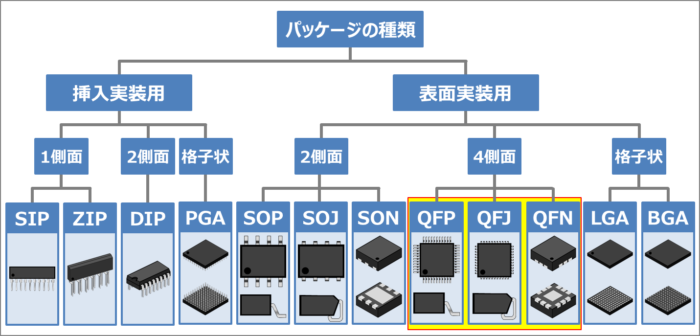
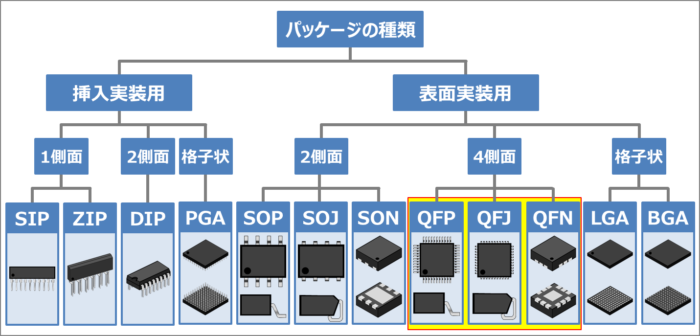
パッケージの4側面からリードが出ているパッケージにはQFが付くものが多いです。QFは『Quad Flat』の頭文字をとったものです。リードの形状はQFの後に来る英文字で決まり、以下のようになります。
QFパッケージのリード形状
- QFP:ガルウィング形
- QFJ:J字形
- QFN:ノンリード(リードなし)
- QFI:I字形
- QFF:フラットリード形
QFP,QFJ,QFN,QFI,QFFの特徴は以下のようになっています。
QFP
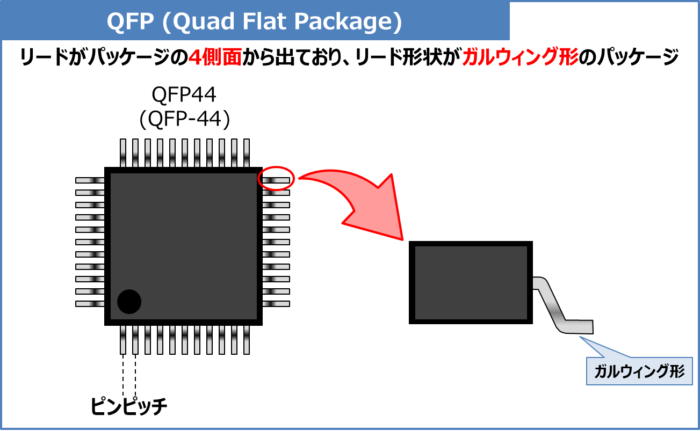
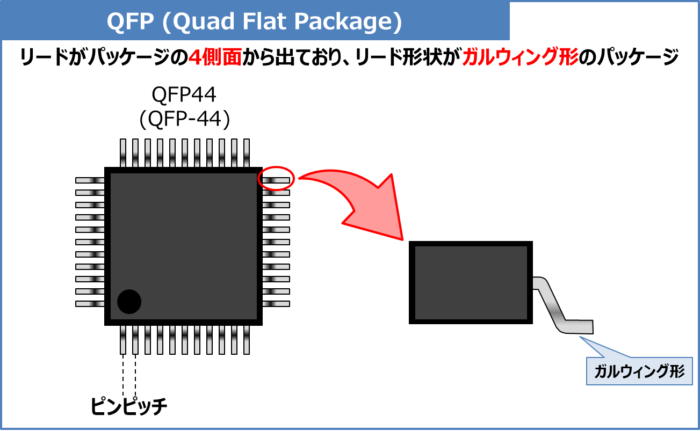
QFPは『Quad Flat Package』の頭文字をとったものです。
QFPはリードがパッケージの4側面から出ており、リード形状がガルウィング形(L字形)のパッケージとなっています。
QFPの後に付く数字はピン数を表します。例えば、QFP44の場合、44ピンのQFP(各辺から11ピン出ている)となります。
ピンピッチは1.0mm,0.8mm,0.65mm,0.5mm,0.4mm,0.3mmなど様々な種類がありますが、ピンピッチが狭くなるにつれてリードピンが曲がりやすくなるので注意してください。
なお、ガルウィング形(L字形)のリードがパッケージの2側面から出ているものは、SOP(Small Outline Package)と呼ばれています。
QFPでも様々な種類があります(BQFP,GQFPなど)。
あわせて読みたい
『QFP(Quad Flat Package)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る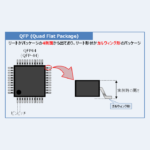
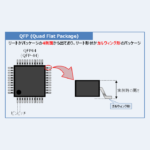
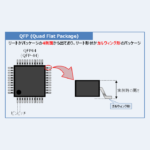
『QFP』とは?パッケージの種類を解説!【半導体&IC】
QFJ
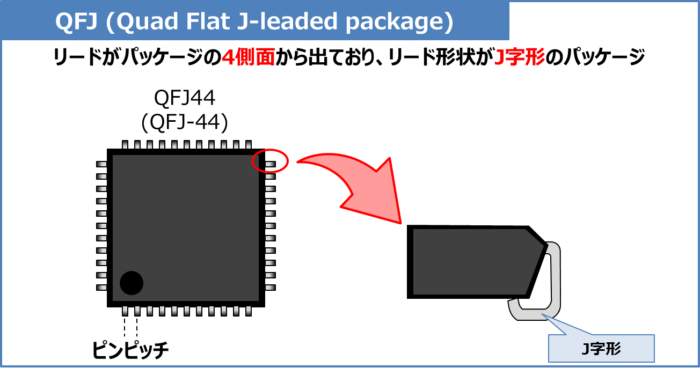
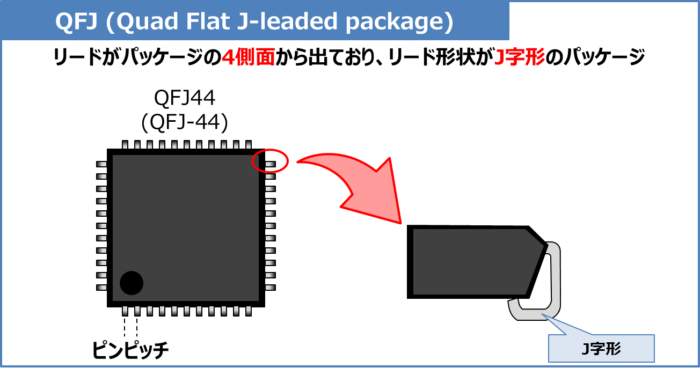
QFJは『Quad Flat J-leaded package』の頭文字をとったものです。
QFJはリードがパッケージの4側面から出ており、リード形状がJ字形のパッケージとなっています。ピンピッチは1.27mmです。
QFJの後に付く数字はピン数を表します。例えば、QFJ44の場合、44ピンのQFJ(各辺から11ピン出ている)となります。
『QFJ』関連の用語として『PLCC』があります。『PLCC』は『Plastic Lead Chip Carrier』の頭文字をとったものであり、パッケージ材質がプラスチックのQFJです。JEITAのパッケージコードでは「P-QFJ」に相当します。
なお、J字形のリードがパッケージの2側面から出ているものは、SOJ(Small Outline J-leaded package)と呼ばれています。
QFJでも様々な種類があります(P-QFJ,C-QFJなど)。
あわせて読みたい
『QFJ(Quad Flat J-leaded package)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る


『QFJ』とは?パッケージの種類を解説!【半導体&IC】
QFN
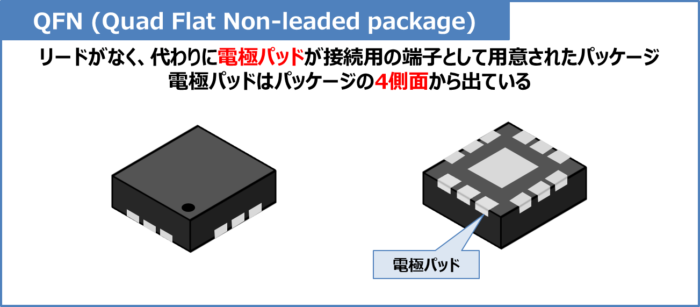
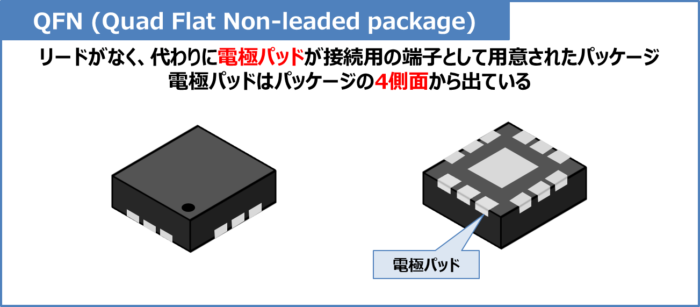
QFNは『Quad Flat Non-leaded package』の頭文字をとったものです。
QFN(Quad Flat Non-leaded package)はリードがなく、代わりに電極パッドが接続用の端子として用意されたパッケージとなっています。電極パッドはパッケージの4側面から出ています。
リードがないため、チップサイズとほぼ同じ大きさでパッケージを製作することができます。
『QFN』関連の用語として『LCC』と『CLCC』があります。『LCC』は『Lead Chip Carrier』の頭文字を、『CLCC』は『Ceramic Lead Chip Carrier』の頭文字をとったものであり、パッケージ材質がセラミックのQFNです。JEITAのパッケージコードでは「C-QFN」に相当します。
なお、電極パッドがパッケージの2側面から出ているものは、SON(Small Outline Non-leaded package)と呼ばれています。
QFNでも様々な種類があります(LQFN,TQFNなど)。
あわせて読みたい
『QFN(Quad Flat Non-leaded package)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る


『QFN』とは?パッケージの種類を解説!【半導体&IC】
QFI
QFIは『Quad Flat I-leaded package』の頭文字をとったものです。
QFIはリードがパッケージの4側面から出ており、リード形状がI字形のパッケージとなっています。
なお、I字形のリードがパッケージの2側面から出ているものは、SOI(Small Outline I-leaded package)と呼ばれています。
QFF
QFFは『Quad Flat F-leaded package』の頭文字をとったものです。
QFFはリードがパッケージの4側面から出ており、リード形状が直線形(フラットリード形)のパッケージとなっています。
なお、直線形(フラットリード形)のリードがパッケージの2側面から出ているものは、SOF(Small Outline F-leaded package)と呼ばれています。
パッケージ底面から格子状に端子が出ているパッケージ


パッケージの底面から格子状に端子が出ているパッケージにはGAが付くものが多いです。GAは『Grid Array』の頭文字をとったものです。リードの形状はGAの前に来る英文字で決まり、以下のようになります。
GAパッケージのリード形状
- PGA:ピン
- LGA:ランド
- BGA:はんだ状のボール
PGAは挿入実装用パッケージ、LGAとBGAは表面実装用パッケージとなっています。PGAはその他の表面実装用パッケージSIP,ZIP,DIPと比較して特徴が大きく異なり、LGAとBGAと一緒に説明した方が分かりやすいため、こちらで説明することにしました。
PGA,LGA,BGAの特徴は以下のようになっています。
PGA
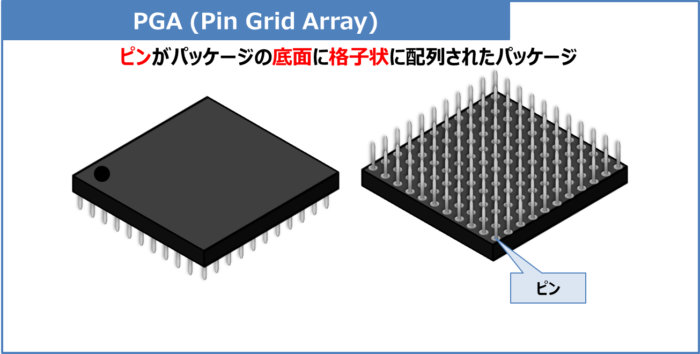
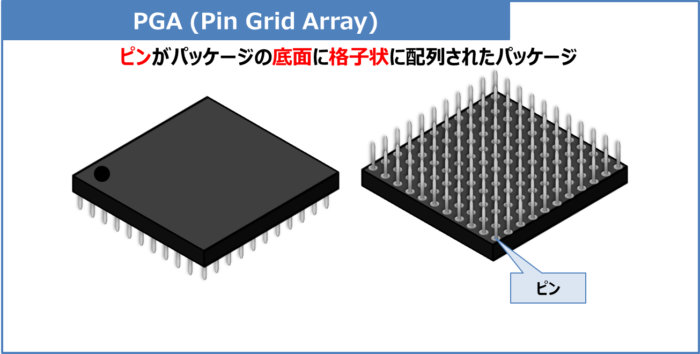
PGAは『Pin Grid Array』の頭文字をとったものです。
PGAはピンがパッケージの底面に格子状に配列されたパッケージとなっています。パッケージから剣山みたいにピンが出ています。
ピンピッチは通常2.54mm(100ミル)となっており、ピン数は400ピン以上配置されることもあります。
表面実装可能なBGA(Ball Grid Array)が開発されるまでは、PGAはパソコン向けのCPU等では多ピンの主流パッケージでした。
PGAでも様々な種類があります(SPGA,IPGAなど)。
あわせて読みたい
『PGA(Pin Grid Array)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る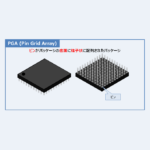
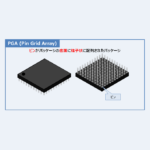
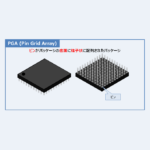
『PGA』とは?パッケージの種類を解説!【半導体&IC】
LGA
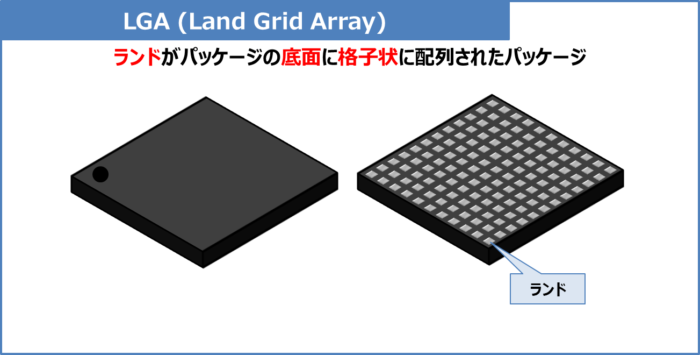
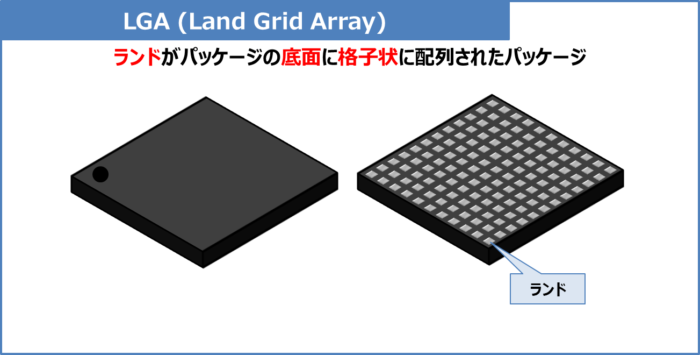
LGAは『Land Grid Array』の頭文字をとったものです。
LGAはランドがパッケージの底面に格子状に配列されたパッケージとなっています。
BGA(Ball Grid Array)と異なり、ソケットによる実装が可能です。剣山型の電極に押し付けるように装着する専用ソケットがあります。また、LGAはBGAの端子であるはんだボールがないため、取り付け高さを低くすることが可能です(JEITA規格では外部端子の高さが0.1mm以下の場合、はんだボールを用いていてもLGAに分類されます)。
LGAでも様々な種類があります(FLGA,ILGAなど)。
あわせて読みたい
『LGA(Land Grid Array)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る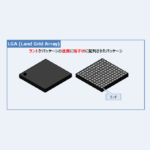
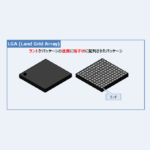
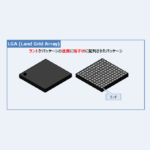
『LGA』とは?パッケージの種類を解説!【半導体&IC】
BGA
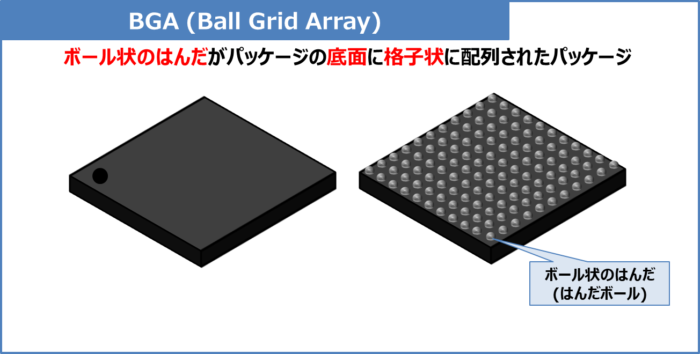
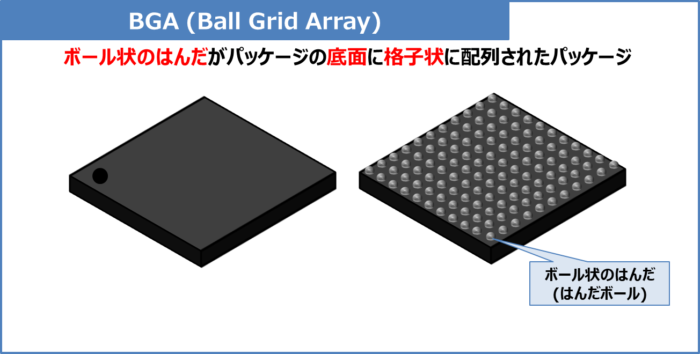
BGAは『Ball Grid Array』の頭文字をとったものです。
BGAはボール状のはんだ(はんだボール)がパッケージの底面に格子状に配列されたパッケージとなっています。
BGAでも様々な種類があります(FBGA,IBGAなど)。
あわせて読みたい
『BGA(Ball Grid Array)』について詳しくは下記の記事で詳しく説明しています。興味のある方は下記のリンクからぜひチェックをしてみてください。 続きを見る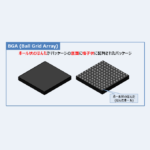
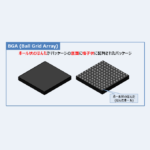
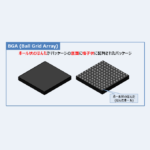
『BGA』とは?パッケージの種類を解説!【半導体&IC】
その他のパッケージと関連用語
今までは下記のパッケージを説明しました。
- 挿入実装用パッケージ
- SIP,ZIP,DIP
- リードが2側面から出ている表面実装用パッケージ
- SOP,SOJ,SON,SOI,SOF(SONのみノンリード)
- リードが4側面から出ている表面実装用パッケージ
- QFP,QFJ,QFN,QFI,QFF(QFNのみノンリード)
- 底面から格子状に端子が出ているパッケージ
- PGA,BGA,LGA
これから先は今まで説明した以外のパッケージとパッケージの関連用語を示しています。
テープを用いるパッケージ
DTP
DTPは『Dual Tape carrier Package』の頭文字をとったものです。
DTPはリードがパッケージの2側面から取り出され、かつテープで構成されたパッケージとなっています。
TAB(Tape Automated Bonding)技術で『ICチップ』と『半導体集積回路を実装したTABテープ(ポリイミドからなるフィルム)』を接合しています。この方法を用いたパッケージはTCP(Tape Carrier Package)とも呼ばれています。
QTP
QTPは『Quad Tape carrier Package』の頭文字をとったものです。
QTPはリードがパッケージの4側面から取り出され、かつテープで構成されたパッケージとなっています。
DTPと同様にTAB(Tape Automated Bonding)技術で『ICチップ』と『半導体集積回路を実装したTABテープ(ポリイミドからなるフィルム)』を接合しています。この方法を用いたパッケージはTCP(Tape Carrier Package)とも呼ばれています。
CSPという名が含まれているパッケージ
CSP
CSPは『Chip Size Package/Chip Scale Package』の頭文字をとったものです。
CSPはBGAのサイズを大幅に小さくし、実装する半導体チップに近い外形寸法を実現したパッケージです。パッケージの外形ではなく特徴を示しているためJEITAでの呼び名はありません。
WL-CSP
WL-CSPは『Wafer Lebel CSP』の頭文字をとったものです。
WL-CSPはウェーハ状態で再配線、封止、外部端子付けを行い、最終的に切り離して個別化することで製造されたCSP(実装する半導体チップに近い外形寸法を実現したパッケージ)となっています。
その他
LLP
LLPは『Leadless Leadframe Package』の頭文字をとったものです。
LLPはリードフレームを用いたCSP用パッケージの一種となっています。
超小型・超薄型のパッケージであり、TSSOPなどよりも小さくなっています。ナショナルセミコンダクター社により開発され、LLPという名称は登録商標となっています。
DFN
DFNは『Dual Flatpack No-leaded』の頭文字をとったものです。
DFNは電極パッドがパッケージの2側面または4側面から出ています。1側面のみに電極パッドがあるものもありますが、一般的には2側面または4側面から出ているものが多く使われています。4側面から出ているものはQFNとも呼ばれています。
LLPとDFNは構造が似ていますが、LLPは端子パッドがパッケージの中に埋め込まれているのに対し、DFNはパッケージの側面から引き出した板状の端子を内側に折り曲げて電極パッドとしています。
MCP
MCPは『Multi Chip Package』の頭文字をとったものです。
MCPは1つのパッケージに複数のチップを搭載したパッケージです。『チップを積層して複数のチップを搭載する場合』と『チップを横に並べて複数のチップを搭載する場合』があります。製造メーカーにより,積層タイプのみをMCPと呼ぶ場合があります。なお、積層タイプのものは「スタックド(スタック型)MCP」と呼ばれることもあります。
MCM
MCMは『Multi Chip Module』の頭文字をとったものです。
MSMは1つのパッケージやモジュールに複数の半導体チップや素子を内蔵したモジュールとなっています。
SiP
SiPは『System in a Package』の頭文字をとったものです。
SiPは1つのパッケージ内に複数の半導体チップを封止したモジュールとなっています。対語は「SOC(System-on-a-chip)」となります。
MCMも1つのパッケージに複数のチップを封止したモジュールですが、SiPはそのパッケージで何かしらのシステム機能を有するというのが特徴となっています。
PoP
PoPは『Package on a Package』の頭文字をとったものです。
PoPはパッケージの上にパッケージを積層する技術です。小さい実装面積で高機能化することができるようになります。
PiP
PiPは『Package in a Package』の頭文字をとったものです。
PiPはパッケージの内部にパッケージを封入する技術です。
QIPまたはQUIP
QIPまたはQUIPは『Quad In-line Package』の頭文字をとったものです。
QIPまたはQUIPはDIPの足を交互にしたパッケージです。なお、SIPの足を交互にしたものはZIPと呼びます。
TSOC
TSOCは『Thin Small Outline Circuit』の頭文字をとったものです。
TSOCはSOJの少ピンバージョンです。ピンピッチは1.27mmでSOJと同じですが、ボディサイズが小型になっています。
CFP
CFPは『Ceramic Flat Package』の頭文字をとったものです。
CFPはセラミック製の薄型パッケージです。構造的にはC-DIPを薄くしたものと似ています。表面実装があまり普及していない時代に開発されたため、ピンを曲げれば挿入実装できるようになっています。
LLCC
LLCCは『Lead Less Chip Carrier』の頭文字をとったものです。
LLCCはセラミック表面に電極パッドを設け、リード線を出さなくしたパッケージとなっています。QFNとも呼ばれることがあります。
FOWLP
FOWLPは『Fan Out Wafer Level Package』の頭文字をとったものです。
FOWLPは多ピンに対応するために半導体チップよりも大きな領域に外部端子を設けた半導体パッケージとなっています。
パッケージの面積が半導体チップよりも大きく、半導体チップよりも大きな領域まで外部端子を広げる(fan out)ことで、より多くの入出力端子を確保しています。BGAと比較して薄型化,短配線長化できることが特徴です。
COB
COBは『Chip On Board』の頭文字をとったものです。
COBは基板上にチップを実装する技術です。基板上に樹脂でチップを搭載し、純金製のワイヤで回路パターンとチップの電極を接続しています。パッケージ品を表面実装するのと比較すると、実装面積の低減、薄型化が可能となります。
COF
COFは『Chip On Film』の頭文字をとったものです。
COFはフレキシブル基板上にチップを実装する技術です。
COBの実装対象は基板でしたが、COFは実装対象が薄く柔軟なフレキシブル基板(ポリイミドのフィルム基板)となっています。
COG
COGは『Chip On Glass』の頭文字をとったものです。
COGはガラス基板上にチップを実装する技術です。
COBの実装対象は基板でしたが、COGは実装対象がガラス基板となっています。COBと比較すると小型化が可能ですが、受動部品はガラス基板上には実装できないため、外付けとなります。
SVP
SVPは『Surface Vertical Package』の頭文字をとったものです。
SVPはリードがパッケージの1側面から出ており、リードがV字形であり、挿入実装用であるパッケージとなっています。
DMP
DMPはピンピッチが1.27mmの新日本無線のパッケージです。SOPやSOICに近い形をしていますが、パッケージの幅が異なります。
まとめ
この記事では『半導体(ICやトランジスタ)のパッケージの種類』について説明しました。
お読み頂きありがとうございました。
当サイトでは電気に関する様々な情報を記載しています。当サイトの全記事一覧は以下のボタンから移動することができます。
また、記事下に当サイトの人気記事を記載しています。ご参考になれば幸いです。







